电巢学堂:器件可靠性与失效分析(2)
【作者】网站采编
【关键词】
【摘要】:2、混合集成电路的失效 混合集成电路工艺: IC工艺:氧化、扩散、镀膜、光刻等 厚膜工艺:基板加工、制版、丝网印刷、烧结、激光调阻、分离元器件组2、混合集成电路的失效
混合集成电路工艺:
IC工艺:氧化、扩散、镀膜、光刻等
厚膜工艺:基板加工、制版、丝网印刷、烧结、激光调阻、分离元器件组装等
薄膜工艺:基板加工、制版、薄膜制备、光刻、电镀等
失效原因:
元器件失效:31%
互连失效:23%,引线键合失效、芯片粘结不良等
沾污失效:21%
关于混合集成电路:
按制作工艺,可将集成电路分为:
(1)半导体集成电路(基片:半导体)
? ? ? ? ?即:单片集成电路(固体电路)
? ? ? ? ?工艺:半导体工艺(扩散、氧化、外延等)
(2)膜集成电路(基片:玻璃、陶瓷等绝缘体)
? ? ? ? ?工艺:
? ? ? ? ?薄膜集成电路——真空蒸镀、溅射、化学气相沉积技术
? ? ? ? ?厚膜集成电路——浆料喷涂在基片上、经烧结而成(丝网印刷技术)
3、混合集成电路(Hybrid Integrated Circuit)
特点:充分利用半导体集成电路和膜集成电路各自的优点,达到优势互补的目的;
工艺:用膜工艺制作无源元件,用半导体IC或晶体管制作有源器件。
三种集成电路的比较:

第三章 微电子封装技术与失效
1、微电子封装的分级:
??零级封装:通过互连技术将芯片焊区与各级封装的焊区连接起来;
? 一级封装(器件级封装):将一个或多个IC芯片用适宜的材料封装起来,并使芯片的焊区与封装的外引脚用引线键合(WB)、载带自动焊(TAB)和倒装焊(FC)连接起来,使之成为有功能的器件或组件,包括单芯片组件SCM和多芯片组件MCM两大类
? 二级封装(板极封装):将一级微电子封装产品和无源元件一同安装到印制板或其他基板上,成为部件或整机。
? 三级封装(系统级封装):将二极封装产品通过选层、互连插座或柔性电路板与母板连接起来,形成三维立体封装,构成完整的整机系统(立体组装技术)
2、微电子的失效机理

(1)热/机械失效
热疲劳
热疲劳失效主要是由于电源的闭合和断开引起热应力循环,造成互连焊点变形,最终产生裂纹
失效分析例子——连接器的过机械应力疲劳损伤
样品:SMA连接器(阴极)
现象:外部插头(阳极)与该SMA接头连接不紧,装机前插拔力检验合格
失效模式:接触不良
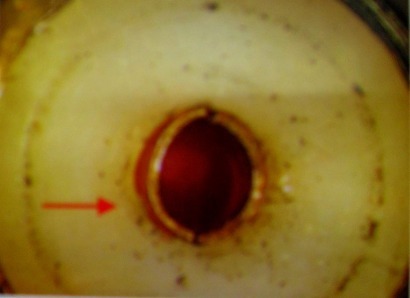
半圆弧夹片明显偏离
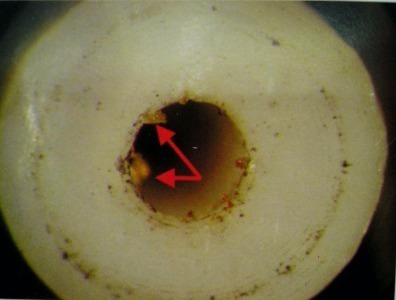
插孔周边绝缘介质有较深的插痕
偏离的半圆夹片根部有裂纹
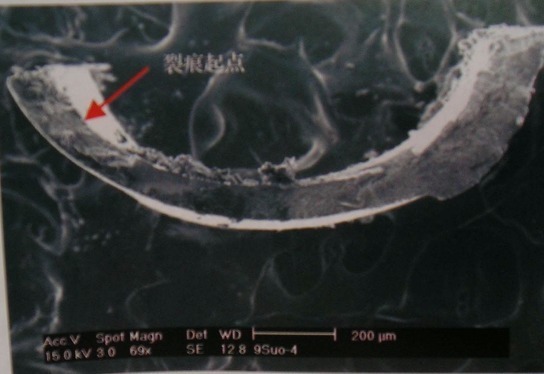
半圆片裂纹断面

蠕变----材料在长时间恒温、恒压下,即使应力没有达到屈服强度,也会慢慢产生塑性变形的现象

蠕变导致焊点断裂
脆性断裂
当应力超过某一值时,陶瓷、玻璃和硅等脆性材料易发生脆性断裂。断裂一般发生在有初始裂纹和刻痕的地方,当原有裂纹扩展到器件的有源区时,器件将失效。
塑性变形
当应力超过材料的弹性限度或屈服点时,将发生塑性变形(永久):
金属:电阻升高或开裂
陶瓷等脆性材料:开裂
MEMS系统:影响精度甚至不能正常工作
封装界面层分层----粘连在一起的不同层之间出现剥离或分离的现象
原因:表面缺陷
表面存在水汽和挥发物
材料不均或表面粗糙等
塑封件因热膨胀系数不同,温度变化大时会出现;
塑封件因吸收过多潮气,在受热例如焊接过程中出现分层(爆米花现象);
BGA封装中,模塑料与基体界的界面及粘胶处易发生水汽爆裂。
应力迁移(Stress Migration)
引子:铜互连替代铝互连,虽然铜的电阻率较低,抗电迁移和应力迁移能力强,但应力迁移诱生空洞,导致电阻增大甚至完全断裂
出现条件:应力梯度—绝缘介质与铜之间的热失配所致
位置:通孔和金属连线边缘等应力集中区域
影响因素:应力、应力梯度、互连结构、工作温度、金属介质界面粘附性、互连材料的微观结构

文章来源:《失效分析与预防》 网址: http://www.sxfxyyf.cn/zonghexinwen/2021/0708/378.html
上一篇:轧机减速箱轴承的电蚀故障诊断及失效分析
下一篇:轧机轴承失效原因分析及预防